主要特点和优势
出色的高密度等离子体
SENTECH SI 500 D 电感耦合 (IC) PECVD 系统具有优异的等离子特性,如高密度、低离子能量、低压等离子沉积电介质薄膜,以及低损耗、低温沉积钝化层。
低应力电感耦合 PECVD
氮化硅的低应力ICPECVDx 作为 GaN HEMT 钝化层和 SiOx 利用该系统,可以在射频和功率器件、光子学等应用中以出色的均匀性和可重复性进行沟槽填充。
SENTECH 专利的等离子源技术
SENTECH 平面三螺旋天线 (PTSA) 源是我们高端 ICP 工艺系统的独特功能。PTSA 源可产生离子密度高、离子能量低的均匀等离子体,适用于高质量、低损伤的电感耦合 PECVD 氧化硅沉积。2Si3N4、a-Si、SiC、DLC 和掺杂层。
沉积层的突出特性
低蚀刻率、高击穿电压、低应力、对基底无损伤,以及极低的界面态密度(沉积温度低于 100 °C)使沉积薄膜具有出色的性能。
动态温度控制
等离子沉积过程中的基底温度设置和稳定性是高质量蚀刻的苛刻标准。具有动态温度控制功能的基底电极与氦气(He)背面冷却和基底背面温度传感器相结合,即使在低温下也能沉积出高质量的层。


MIM 结构
采用 ICPECVD SiNx 薄膜
砷化镓像素上的 ICPECVD SiNx 薄膜 –
沉积工艺的高度一致性
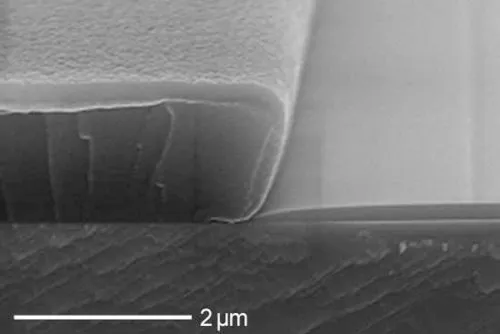
低温 SiNx –
用于升空工艺的 ICPECVD 薄膜

硅边缘沉积的二氧化硅条纹 –
ICPECVD的高保形性
SENTECH SI 500 D ICPECVD 该系统代表了电感耦合等离子体 (ICP) 处理在研究和工业领域的领先水平,可用于等离子体增强的电介质薄膜、非晶硅、碳化硅和其他材料的化学气相沉积。该系统由 ICP 等离子源 PTSA、动态温控基底电极和完全可控的真空系统组成。SENTECH 内置的灵活负载锁可处理从 100 毫米晶圆到 200 毫米直径的各种基底以及载体上的基底。 SI 500 D.单晶片真空负载锁和机械夹具可确保稳定的条件,并可直接切换工艺。
灵活性和模块化

- ICPECVD 等离子沉积系统
- 带真空负载锁
- 最大 200 毫米晶圆
- 基底温度从 RT 至 350 °C
- 激光端点检测
- 可选基底偏压






